
测试服务
全部分类
-
开封Decap
-
去层Delayer
-
高分辨率显微镜X-Ray
-
时域反射仪TDR
-
增强型热成像Thermal
-
双束聚焦离子束FIB
-
等离子聚焦离子束PFIB
-
微光显微镜EMMI
-
激光故障定位法OBIRCH
-
纳米探针Nano Probe
-
EBIC/EBAC
-
上机观察SEM
-
透射电子显微镜TEM
-
能量色散X射线光谱仪EDX
-
原力电子显微镜AFM
-
芯片线路修改/FIB CKT 线路修补 (低阶)、(高阶)
-
飞行时间二次离子质谱仪TOF-SIMS
-
磁质谱仪D-SIMS
-
俄歇电子能谱AES
-
X射线光电子能谱(XPS)
-
傅里叶变换红外光谱仪FTIR
-
原子力显微镜AFM
-
静电ESD
-
打线WireBond
-
扩展电阻测试SRP
-
温度循环实验TC
-
温度冲击试验TS
-
高温寿命试验HTOL
-
高加速寿命测试HAST
-
器件DPA
-
植球Balling
等离子聚焦离子束PFIB
- 分类:测试服务
- 发布时间:2022-05-18 15:38:29
- 访问量:0
概要:PFIB使用Xe氙作为离子源,Xe源电流2500nA,在离子材料去除上有更高的速率。双束PFIB配备SEM实时成像,用于1000微米以内大尺寸切片,芯片局部去层可配合NanoProbe。
详情
1、项目定义:
PFIB使用Xe氙作为离子源,Xe源电流2500nA,在离子材料去除上有更高的速率。双束PFIB配备SEM实时成像,用于1000微米以内大尺寸切片,芯片局部去层可配合Nano Probe。
2、应用优势:
由于其离子电流比Ga高38倍,适用于SEM定位大尺寸的切割,芯片热点位置可进行定点去层,大尺寸样品可以边切边观察,便于分析测试,配合Nano Probe、CAFM、EBSD制备,可以解决客户3D防撞TSV定点截面分析、MEMS结构无形截面分析、光芯片光路截面分析、失效孤品去层分析的需求。
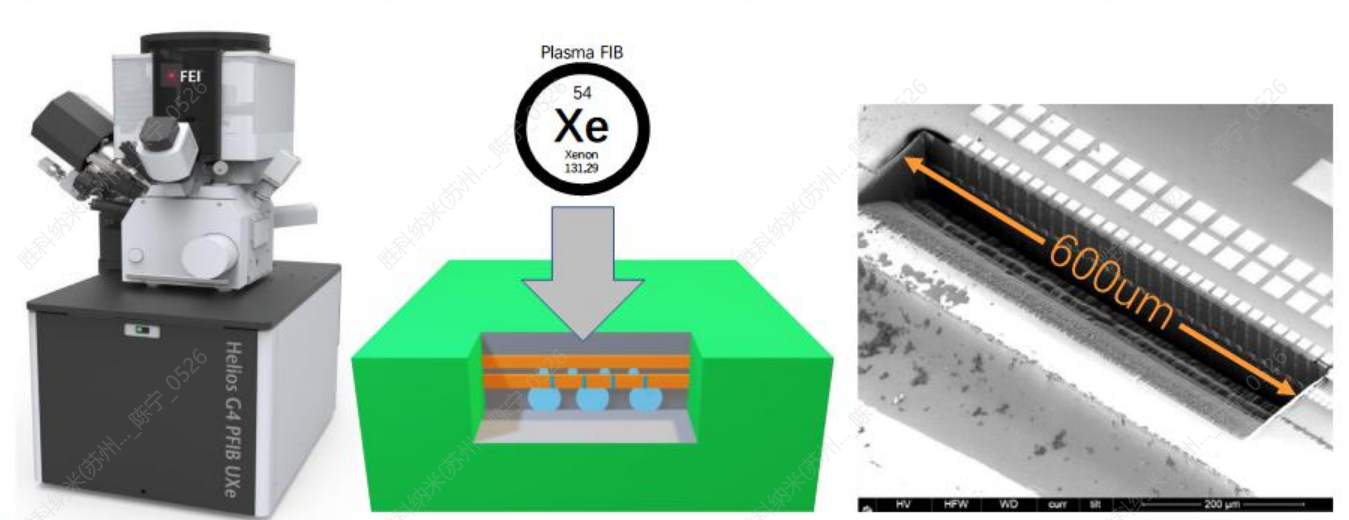
扫二维码用手机看


 0512-62800006
0512-62800006

 sales-cn@wintech-nano.com
sales-cn@wintech-nano.com
