
测试服务
全部分类
-
开封Decap
-
去层Delayer
-
高分辨率显微镜X-Ray
-
时域反射仪TDR
-
增强型热成像Thermal
-
双束聚焦离子束FIB
-
等离子聚焦离子束PFIB
-
微光显微镜EMMI
-
激光故障定位法OBIRCH
-
纳米探针Nano Probe
-
EBIC/EBAC
-
上机观察SEM
-
透射电子显微镜TEM
-
能量色散X射线光谱仪EDX
-
原力电子显微镜AFM
-
芯片线路修改/FIB CKT 线路修补 (低阶)、(高阶)
-
飞行时间二次离子质谱仪TOF-SIMS
-
磁质谱仪D-SIMS
-
俄歇电子能谱AES
-
X射线光电子能谱(XPS)
-
傅里叶变换红外光谱仪FTIR
-
原子力显微镜AFM
-
静电ESD
-
打线WireBond
-
扩展电阻测试SRP
-
温度循环实验TC
-
温度冲击试验TS
-
高温寿命试验HTOL
-
高加速寿命测试HAST
-
器件DPA
-
植球Balling
植球Balling
- 分类:测试服务
- 发布时间:2022-08-10 16:38:50
- 访问量:0
概要:
详情
植球介绍
BGA植球即球栅阵列封装技术。该技术的出现便成为CPU、主板南、北桥芯片等高密度、高性能、多引脚封装的最佳选择。(资料来源于360百科)
1、芯片封装分类:BGA、CSP
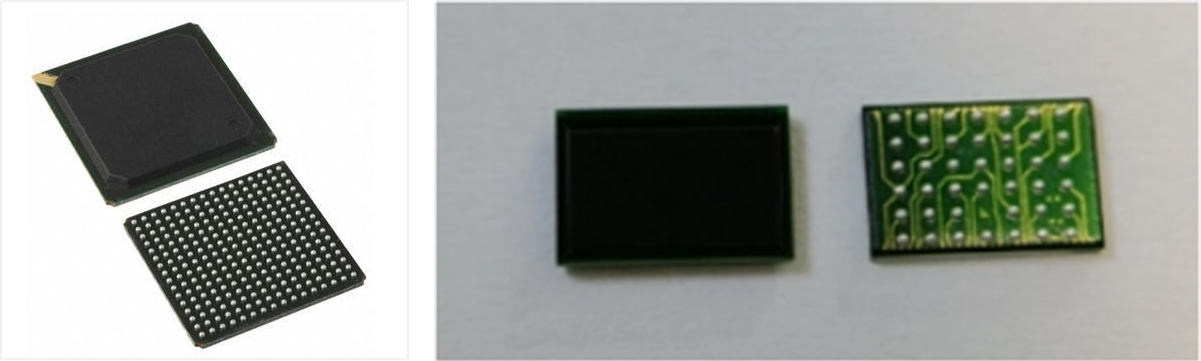
锡球的选用:现在市场上有0.2mm-0.76mm
植球手法:手动植球法、夹具植球法
2、使用工具

| 1 热风枪/电烙铁 | 2 ESD镊子 | 3 吸锡带 | 4 助焊膏 | 5 锡球 | 6 无尘布 |
| 7 清洁水 | 8 软毛刷 | 9 夹具/钢网 | 10 高温胶带 | 11 静电环 |
3、使用夹具植球方法
• 配戴好静电环,防止静电损坏芯片。检查芯片外观是否破损。
• 夹具固定芯片,用吸锡带清理干净芯片上的残锡。
• 清洁水清理干净芯片,均匀的涂抹适量的助焊膏。
• 盖上钢网,倒入锡球;用拨片或上下左右晃动,使所有钢网孔内铺满锡球。
• 取下钢网,机台预热后加温230度,时间5~10秒,加热固定锡球。
• 稍微冷却一下,检查锡球有无虚焊,涂助焊膏二次加热。
• 冷却后,清洁水清理芯片。用放大镜检查每颗锡球是否焊好。
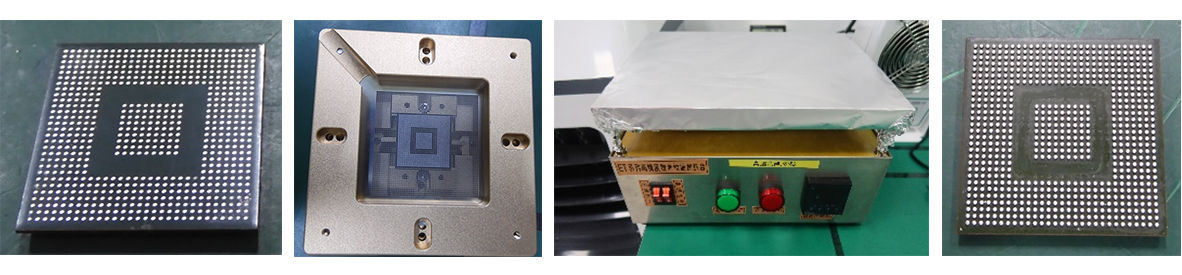
4、手工摆球植球方法
• 配戴好静电环,防止静电损坏芯片,检查芯片外观是否破损
• 使用高温胶带固定芯片
• 吸锡带清理残锡,均匀涂抹助焊膏
• 用ESD镊子将锡球依次摆满芯片
• 热风枪温度340度/风速0档/时间5~10秒
• 检查锡球有无虚焊,涂助焊膏二次加热
• 清洁水清理芯片
扫二维码用手机看


 0512-62800006
0512-62800006

 sales-cn@wintech-nano.com
sales-cn@wintech-nano.com
